案例&资讯
存储器芯片的多种封装技术
来源:宇芯有限公司 日期:2017-12-06 15:06:38
存储器芯片的封装有多种选择,包括从引脚数少、外形小的SOP封装到引脚数多的硅通孔(TSV)等各种封装技术,而这些技术的选择取决于密度、性能和成本等产品要求。Yole分析确定了五个核心存储器芯片封装平台:引线键合BGA、引线框架、倒装芯片BGA、晶圆级芯片尺寸封装(WLCSP)、硅通孔(TSV)。每种技术都包括许多不同的变化形式,并拥有不同的术语。我们预计2016~2022年整个存储器芯片封装市场的复合年增长率为4.6%,2022年将超过250亿美元。
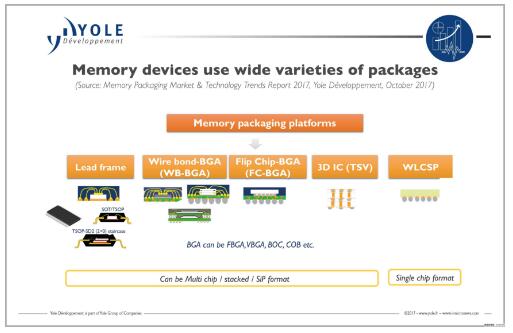
存储器芯片的封装类型
2016年,引线键合BGA占据存储器芯片封装市场的80%以上份额。同样是在2016年,倒装芯片BGA开始进入DRAM存储器芯片封装市场,预计未来五年将以20%的复合年增长率成长,将占据整个存储器芯片封装市场的10%左右市场份额。随着高带宽需求的推动,DRAM/PC服务器领域的应用日益增多,促进了倒装芯片市场的增长。三星电子(Samsung)已经将其90%以上的DRAM芯片封装转换为倒装芯片,SK海力士也开始转型,其它厂商未来也都将逐步采用倒装芯片。事实上,所有用于PC/服务器上的DDR5存储器最终都将使用倒装芯片。
由于高带宽和存储器芯片对各种应用中的高性能计算的低延迟需求,硅通孔(TSV)正被用于高带宽存储器芯片中。2016年硅通孔(TSV)市场在存储器芯片封装市场中的份额不到1%,但是未来五年的复合年增长率超过30%,预计到2022年,硅通孔(TSV)市场份额将达到8%。同时,晶圆级芯片尺寸封装(WLCSP)将被NOR闪存和利基市场的存储器(EEPROMs / EPROM / ROM)采用,预计其复合年增长率超过10%,不过到2022年,晶圆级芯片尺寸封装(WLCSP)市场份额还不到1%。
对于移动应用,存储器芯片封装将主要维持在引线键合BGA平台上,将会很快开始向高端智能手机的多芯片封装(ePoP)迈进。NAND闪存芯片的主要要求是低成本的高存储密度。NAND采用引线键合堆叠形式,以便在单个封装中提供高密度。
NAND闪存芯片封装将保持采用引线键合BGA形式,不会迁移到倒装芯片。但是,东芝将开始在NAND闪存芯片中使用硅通孔(TSV)来提高高端应用的数据传输速率。在东芝之后,我们相信三星电子和SK海力士将会推出硅通孔(TSV)封装的NAND芯片。
关键词:存储器芯片 NAND闪存 DRAM
上一篇:存储芯片市场年均增长9%
宇芯有限公司自成立以来,我们专注于代理国内外各大知名品牌的半导体元器件,代理品牌有NETSOL、JSC、everspin、来杨Lyontek、ISSI、CYPRESS等多个品牌总代理资质,主要产品线为sram、mram、psram等其他存储器芯片,致力于为客户提供具有竞争优势的产品,是一家专业提供存储方案解决商。
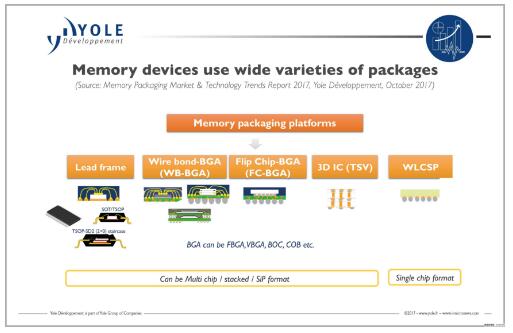
存储器芯片的封装类型
2016年,引线键合BGA占据存储器芯片封装市场的80%以上份额。同样是在2016年,倒装芯片BGA开始进入DRAM存储器芯片封装市场,预计未来五年将以20%的复合年增长率成长,将占据整个存储器芯片封装市场的10%左右市场份额。随着高带宽需求的推动,DRAM/PC服务器领域的应用日益增多,促进了倒装芯片市场的增长。三星电子(Samsung)已经将其90%以上的DRAM芯片封装转换为倒装芯片,SK海力士也开始转型,其它厂商未来也都将逐步采用倒装芯片。事实上,所有用于PC/服务器上的DDR5存储器最终都将使用倒装芯片。
由于高带宽和存储器芯片对各种应用中的高性能计算的低延迟需求,硅通孔(TSV)正被用于高带宽存储器芯片中。2016年硅通孔(TSV)市场在存储器芯片封装市场中的份额不到1%,但是未来五年的复合年增长率超过30%,预计到2022年,硅通孔(TSV)市场份额将达到8%。同时,晶圆级芯片尺寸封装(WLCSP)将被NOR闪存和利基市场的存储器(EEPROMs / EPROM / ROM)采用,预计其复合年增长率超过10%,不过到2022年,晶圆级芯片尺寸封装(WLCSP)市场份额还不到1%。
对于移动应用,存储器芯片封装将主要维持在引线键合BGA平台上,将会很快开始向高端智能手机的多芯片封装(ePoP)迈进。NAND闪存芯片的主要要求是低成本的高存储密度。NAND采用引线键合堆叠形式,以便在单个封装中提供高密度。
NAND闪存芯片封装将保持采用引线键合BGA形式,不会迁移到倒装芯片。但是,东芝将开始在NAND闪存芯片中使用硅通孔(TSV)来提高高端应用的数据传输速率。在东芝之后,我们相信三星电子和SK海力士将会推出硅通孔(TSV)封装的NAND芯片。
关键词:存储器芯片 NAND闪存 DRAM
上一篇:存储芯片市场年均增长9%
宇芯有限公司自成立以来,我们专注于代理国内外各大知名品牌的半导体元器件,代理品牌有NETSOL、JSC、everspin、来杨Lyontek、ISSI、CYPRESS等多个品牌总代理资质,主要产品线为sram、mram、psram等其他存储器芯片,致力于为客户提供具有竞争优势的产品,是一家专业提供存储方案解决商。





